|
|
Вторично-ионная масс-спектрометрияЛЕКЦИЯ 6 Спектрометрия ионного рассеяния
Рис. 1. Спектр, полученный при анализе по энергиям рассеянных первичных ионов. Основной метод, использующий анализ по энергиям, называют спектрометрией ионного рассеяния (ISS — СИР). Предполагают, что бомбардирующий ион претерпевает простое парное столкновение с атомом мишени и теряет энергию в результате простого обмена кинетической энергией. Исходя из этого, можно рассчитать энергию рассеянного первичного иона как функцию массы рассеивающего атома и угла рассеяния. При фиксированном значении последнего (его часто выбирают равным 90°) отношение энергии отраженной первичной частицы к ее начальной энергии оказывается простой функцией отношения масс рассеивающего атома и бомбардирующего иона. Следовательно, эксперимент сводится к облучению поверхности первичным пучком с энергией порядка нескольких килоэлектронвольт и энергоанализу отраженных первичных частиц. Таким образом, получают спектр, аналогичный изображенному на рис. 1. Если первичный пучок проник в глубь образца, вероятность того, что ион испытает в объеме материала простое парное столкновение и затем выйдет обратно без дополнительной потери энергии, очень мала. Следовательно, такой метод очень чувствителен к поверхности и получаемый сигнал должен быть связан почти исключительно с поверхностным моноатомным слоем, а вклад второго или третьего слоя, по-видимому, предельно мал. Важное достоинство этого метода заключается в простоте аппаратуры и высокой чувствительности к моноатомному поверхностному слою атомов. Сложность же его применения связана в основном с проблемой создания контролируемого ионного пучка в условиях, когда вблизи образца обычно необходимый для многих поверхностных экспериментов. Как можно видеть из фиг. 9, разрешение прибора, достигаемое при разумном отношении сигнала к шуму, невелико, Кроме того, бомбардировка ионами с энергией порядка нескольких килоэлектронвольт вызывает значительное физическое разрушение образца. Таким образом, чтобы провести аккуратный эксперимент по анализу поверхности, необходимо взять зондирующий пучок с возможно более низкой плотностью тока, а тогда, очевидно, потребуется очень высокая чувствительность при детектировании частиц. При всех своих указанных недостатках данный метод позволяет проводить элементную идентификацию поверхностных компонентов, обходясь весьма простым экспериментальным оборудованием. Несмотря на то, что при ионном облучении поверхность разрушается, сам процесс распыления может быть использован для достижения определенных целей. Так, можно попытаться провести анализ поверхности, используя минимально возможную плотность зондирующего пучка. После того как спектр получен, можно увеличить плотность ионного тока и удалить путем распыления один или более атомных слоев. Затем можно вновь снизить плотность пучка до уровня, необходимого для анализа, и получить спектр, характеризующий состав новой поверхности. Чередуя такие операции, можно получить профиль концентрации. Если вместо анализа по энергиям отраженных первичных частиц проводить масс-анализ распыленных ионов, то мы получим метод, который обычно именуют вторично-ионной масс-спектрометрией (SIMS — ВИМС). В этом методе блок зондирующей пушки остается таким же, как и в спектрометрии ионного рассеяния, и лишь энергоанализатор заменяется соответствующим масс-спектрометром. В таком эксперименте можно определить число и вид как положительных, так и отрицательных ионов, выбитых из поверхности. Можно указать ряд существенных отличий данного метода от спектроскопии ионного рассеяния. Во-первых, намного больше разных видов вторичных ионов. Во-вторых, значительно выше разрешение анализатора. Большое число пиков вторичных ионов значительно усложняет спектр, но в то же время несет более детальную информацию о химических процессах на поверхности. Вторично-ионная масс-спектрометрия Взаимодействие быстрых ионов с твердым телом приводит к выбиванию атомов и молекул материала как в нейтральном, так и в заряженном состоянии. На таком явлении сравнительного эффективного образования вторичных ионов и на принципе высокочувствительных масс-спектрометрических измерений и основан метод ВИМС. Хотя у него, как у любого другого метода, имеются свои недостатки, только он один дает столь широкие возможности исследования и поверхности, и объема твердого тела в одном приборе. Наиболее важными характерными особенностями метода, которые вызывают повышенный интерес к нему, являются очень низкий порог чувствительности для большинства элементов (меньше 10-4 моноатомного слоя), измерение профилей концентрации малых количеств примесей с разрешение по глубине меньше 50А, разрешение по поверхности порядка микрометра, возможность изотопического анализа и обнаружение элементов с малыми атомными номерами (H, Li, Be и т. д.). Рассмотрим процесс взаимодействия ионов с веществом. Падающий ион с энергий 1 - 100 кэВ может обратно рассеиваться атомом или группой атомов бомбардируемого образца. Процесс обратного рассеяния обычно приводит к отклонению траектории иона от первоначального направления после столкновения и к упругому или неупругому в зависимости от типа взаимодействующих частиц и энергии иона обмену энергией между ионом и атомом мишени. Импульс иона может быть достаточно велик для того, чтобы сместить поверхностный атом из положения, где он слабо связан с кристаллической структурой образца, в положение, где связь оказывается сильнее. Этот процесс называется атомной дислокацией. Ионы с более высокими энергиями могут вызывать внутренние дислокации в толще образца. Может происходить выбивание атомов с поверхности объекта, т.е. физическое распыление. Ионы могут проникать в кристаллическую решетку и захватываться там, т.е. ионная имплантация. В результате химических реакций ионов с поверхностными атомами могут образовываться новые химические соединения, причем верхний слой атомов может оказаться в газообразном состоянии и испариться, т.е. химическое распыление. Бомбардирующие положительные ионы в результате процессса оже-нейтрализации могут приобретать на поверхности электроны и отражаться от нее в виде нейтральных атомов. Ионы могут оказаться связанными с поверхностью образца, т.е. адсорбироваться. При ионной бомбардировке металлических поверхностей в определенных условиях возможно возникновение вторичной электронной эмиссии. Наконец, если поверхностные атомы возбуждаются до ионизированных состояний и покидают образец, имеет место вторичная ионная эмиссия. Замедляясь, ион передает энергию твердому телу. При анализе процессов потери энергии различают два основных механизма: соударения с электронами и соударения с ядрами. Кроме того, вклад в энергетические потери дает обмен зарядами между движущимся ионом и атомом мишени. Этот процесс наиболее эффективен, когда относительная скорость иона сравнима с боровской скоростью электрона ( ~106 м/с) . При малых энергиях ионов преобладает взаимодействие с ядрами, которое приводит к появлению угловой расходимости пучка. При высоких энергиях более существенными становятся столкновения с электронами.
Рис. 2. Схематическое представление взаимодействия ионов с мишенью. Неупругие взаимодействия с электронами мишени вызывают вторичную электронную эмиссию, характеристическое рентгеновское излучение и испускание световых квантов. Упругие взаимодействия приводят к смещению атомов кристаллической решетки, появлению дефектов и поверхностному распылению. Эти процессы схематически проиллюстрированы на рис. 2. Энергетический спектр рассеянных твердотельной мишенью ионов с начальной энергией Е0 схематически представлен на рис. 3. Здесь видны широкий низкоэнергетический (10 - 30 эВ) горб, соответствующий испусканию нейтральных атомов, и высокоэнергетический горб, расположенный вблизи энергии первичного иона Е0 (упругорассеянные ионы). Если ион с массой М1 и начальной энергией е0 рассеивается на атоме мишени с массой М2 на угол qL, его энергия Е1 определяется соотношением, которое вытекает из законов сохранения кинетической энергии и импульса:
В случае угла рассеяния 90°, часто используемого на практике, это равенство принимает вид
Таким образом, шкала энергий совпадает со шкалой масс атомов, находящихся на поверхности мишени, и более высокая энергия соответствует большей массе. Формула справедлива при М2>М1. В противном случае существует предельный угол рассеяния, меньший 90°, а энергия Е1 оказывается неоднозначной функцией угла (в фигурных скобках вместо знака + появляется ±). Вторично-ионная эмиссия Коэффициент вторичной ионной эмиссии SА±, т. е. число (положительных или отрицательных) ионов на один падающий ион, для элемента А в матрице образца дается выражением SА±=gА±САS, (3) где gА± - отношение числа вторичных ионов элемента А к полному числу нейтральных и заряженных распыленных частиц данного элемента, а СА -атомная концентрация данного элемента в образце. Множитель S - полный коэффициент распыления материала (число атомов на один первичный ион). В него входят все частицы, покидающие поверхность, как нейтральные, так и ионы.
Рис. 3. Энергетический спектр электронов, рассеянных при соударении с твердотельной мишенью.
Вторичный ионный ток iА± (число ионов в секунду), измеряемый в приборе ВИМС, дается выражением iА± =hASA±IP, (4) где iА± - ионный ток для моноизотопного элемента. Величина hA -эффективность регистрации ионов данного изотопа в используемом приборе ВИМС, IP полный ток первичных ионов (число ионов в секунду), падающих на образец. Самое важное значение в вопросе о возможностях ВИМС как метода анализа поверхностей имеет взаимосвязь между параметрами пучка первичных ионов, скоростью распыления поверхности и порогом чувствительности для элементов. Соотношения между током первичных ионов, диаметром и плотностью пучка, скоростью распыления поверхности и порогом чувствительности при типичных условиях иллюстрируются графиком, представленным на рис. 4. При построении графика предполагается, что площадь захвата анализатора, из которой вторичные ионы отбираются в анализатор, не меньше сечения пучка первичных ионов. Данное условие обычно выполняется, если диаметр области, из которой поступают ионы, не превышает 1 мм. Методом ВИМС анализ поверхности можно проводить в двух разных режимах: при малой и большой плотности тока, распыляющего образец. В режиме малой плотности распыляющего тока изменяется состояние лишь малой части поверхности, благодаря чему почти выполняется основное требование, предъявляемое к методам анализа поверхности. В режиме высоких плотностей токов проводится измерение профилей распределения элементов по глубине, микроанализ и определение следовых количеств элементов (<10-4%). В соответствии со всеми этими вариантами создан ряд приборов ВИМС, в которых применяются разные способы создания и фокусировки первичных ионных пучков и разные анализаторы вторичных ионов.
Рис. 4. Зависимость между током первичных ионов, диаметром и плотностью первичного пучка, скоростью удаления атомных слоев и порогом чувствительности ВИМС. Оборудование ВИМС. Установка ВИМС состоит из четырех основных блоков: источника первичных ионов и системы формирования пучка, держателя образца и вытягивающей вторичные ионы линзы, масс-спектрометра для анализа вторичных частиц по отношению массы к заряду (m/е) и высокочувствительной системы регистрации ионов. Для получения первичных ионов в большинстве установок используются газоразрядные или плазменные источники. Совместно с соответствующей системой формирования и транспортировки пучка эти источники обеспечивают широкий диапазон скорости распыления поверхности - от 10-5 до 103 А/с. Разделение вторичных частиц по m/е производится либо магнитными, либо квадрупольными анализаторами. Источники ионов Наиболее подходят для СВИМС несколько источников ионов. Источник ионов с ионизацией рабочего газа электронным ударом - наиболее простой тип ионных источников.O2, Ar или другой, чаще всего инертный, газ пропускается через зону ионизации. Источник состоит из немагнитного корпуса, термокатода 4, анода 1, экрана 3, извлекающего электрода 5 и цилиндрического электрода 6, который вместе с 5 образует иммерсионную электростатическую линзу. Применение фокусирующей линзы объясняется необходимостью компенсации рассеивающего действия электромагнитного поля. Источник работает следующим образом. Дуговой разряд образуется в области 2 под действием потока электронов, эмитируемых термокатодом 4. Рабочий газ поступает в область катода и при движении атомов к выходному отверстию под действием потока ускоренных электронов ионизируются. Максимальная концентрация ионизованных атомов рабочего газа находится в зоне извлечения ионов. Газовый разряд стабилизируется магнитным полем (в данном случае полем циклотрона). Типичный ток пучка ионов 1 – 2 А при напряжении разряда 100 – 300 В и ускоряющем напряжении несколько десятков кВ. В режиме получения пучка электронов на ускоряющем электроде необходимо изменить знак заряда. Тогда при всех остальных одинаковых условиях можно получить поток электронов током до 100 – 500 мА.
Рис. 5. Схема источника с ионизацией электронным ударом Источник ионов с газовым разрядом в однородном магнитном поле (разряд Пеннинга).В ионном источнике с разрядом Пеннинга плазма создается осцилляцией электронов в продольном магнитном поле (рис. 6).
Рис. 6. Источник ионов с разрядом в однородном магнитном поле: 1 – изоляционное кольцо; 2 – цилиндрический анод; 3 – магнит; 4 – магнитопровод; 5 – фланец-катод; 6 – извлекающий электрод.
Анод 2 имеет обычно форму плоского кольца или полого цилиндра, по обеим сторонам которого на некотором расстоянии расположены два катода, имеющие в простейшем случае форму плоских дисков. В катоде 5 имеется отверстие. Магнитное поле создается постоянным магнитом 3 и ориентировано вдоль оси системы. При определенной разности потенциалов между анодом и катодами возникает газовый разряд. Благодаря кольцевой форме анода, а также указанной ориентации магнитного поля большая часть электронов, двигаясь по спирали в направлении анода (например, от катода, расположенного сверху) пролетает мимо анода и попадает в нижнюю область. Здесь электроны тормозятся и начинают двигаться в обратном направлении, т.е. совершать колебания относительно анода. Таким образом, прежде чем попасть на анод, электроны многократно пролетают пространство между катодами, ионизируя при этом газ, находящийся в объеме. Образовавшиеся ионы движутся по направлению к катодам, через центральное отверстие одного из них (в данном случае нижнего) вытягиваются электродом и попадают в пространство фокусировки и предварительного ускорения. Напряжение горения разряда зависит от материала катодов. Катоды, выполненные из алюминия, магния, бериллия, железа, позволяют снизить напряжение зажигания разряда до 350–500 В. Характерные размеры электродной системы: диаметр отверстия в аноде 20–30 мм, расстояние между катодами 25 мм, диаметр отверстия в катоде 1–2 мм. Индукция магнитного поля составляет величину около 0,1–0,5 Тл. Такие источники могут работать в непрерывном и импульсном режимах. В них анодное напряжение не превышает 2–3 кВ, расход газа 20–30 см3/ч, ток пучка 1–10 мА в непрерывном и 10–300 мА в импульсном режимах. С помощью такого источника можно получить содержание частиц, например, протонов 60–90 %. Основным недостатком источника Пеннинга является большой разброс ионов по энергии, достигающий 100 эВ и более. Однако эти источники надежны в работе, просты в эксплуатации и находят применение как в линейных, так и в циклических ускорителях. Источник типа дуоплазматрона. К числу наиболее совершенных ионных источников относится дуоплазмотрон (рис. 7), в котором для получения ионов используют дуговой разряд с накаленным катодом при наличии магнитного поля. В нем плотность плазмы увеличивается путем последовательного сжатия потока электронов в электрическом и магнитном полях. Промежуточный электрод конической формы с отверстием малого диаметра и анод сделаны из чистого железа. Анод имеет вольфрамовую центральную вставку с отверстием. Промежуточный электрод и анод выполняют роль магнитопровода. В зазоре между ними возникает сильное неоднородное магнитное поле. В таком источнике анод имеет нулевой потенциал. На катод подают напряжение (–100 В), напряжение на промежуточном электроде (–50 В). Вытягивающее напряжение – (5–60) кВ. Под действием приложенной разности потенциалов между накаленным катодом и промежуточным электродом возникает дуговой разряд низкого давления. В сужении промежуточного электрода происходит сжатие разряда и существенно возрастает концентрация заряженных частиц. В зазоре между промежуточным электродом и анодом электроны двигаются в сильно неоднородном магнитное поле. В результате происходит вторичное сжатие разряда и концентрация ионов увеличивается до 10–12 – 10–14 см–3. При такой плотности плазма приобретает положительный потенциал относительно анода. Это приводит к тому, что часть электронов возвращается обратно в плазму. Поток ионов к аноду увеличивается, что в значительной степени определяет эмиссионные характеристики дуоплазматрона. Отбор ионов из области анодного отверстия обеспечивается с помощью вытягивающего электрода. При оптимальном его расположении и правильно выбранном ускоряющем напряжении получают слаборасходящийся ионный пучок, который попадает в систему электростатического доускорения и фокусировки. Все конструкции дуоплазматронов имеют высокую газовую экономичность при почти полной ионизации газа, что обеспечивает высокое содержание атомарных ионов. Разброс энергии ионов в пучке не превышает 10 эВ. Ионный ток в импульсном режиме может достигать 1 А. Давление рабочего газа должно находиться в интервале величин р = 3–0,1 Па, что оказывает значительную нагрузку на вакуумную систему установки. Поэтому ускорители, где в качестве источника ионов применяется доуплазматрон, имеют развитую (дифференциальную) вакуумную систему с использованием различных типов высоковакуумных насосов. Доуплазматрон может быть также эффективным источником отрицательных ионов. Например, для получения пучка отрицательных ионов водорода отверстие вытягивающего электрода специально смещают относительно канала в анодной вставке.
Рис. 6. Схема дуоплазмотронной ионной пушки. Бомбардировка реактивными частицами увеличивает выход ионизации, что приводит к повышению чувствительности ВИМС. Электроположительные элементы более чувствительны к бомбардировке кислородом, электроотрицательные - к бомбардировке цезием. Поэтому в динамическом режиме ВИМС обычно используются ионы Cs+ или O2+. Другой тип ионных пушек производит положительные ионы из жидкого металла (почти всегда галлия) по методу, показанному схематично на рис. 7. Тонкая игла f (с радиусом наконечника ~5 мкм) тугоплавкого металла проникает через капиллярную трубу d в резервуар с жидким металлом e. Жидкость вытекает через трубу по наконечнику иглы под действием капиллярных сил. Приложение смещения 10-30 кэВ между иглой и близлежащим электродом экстрактора (b) вытягивает жидкость в острие (конус Тэйлора) в результате объединенных сил поверхностного натяжения и электростатического напряжения. Затем ионы ускоряются и фокусируются. Галлий используется, так как температура его плавления 30 °C, т.е. он остается жидким при комнатной температуре. Поскольку производство ионов происходит в очень маленьком объеме, такие ионные пушки очень яркие. В результате, пучок ионов может быть сфокусирован в пятно размером 0.2 мкм при 8-10 кэВ, которое можно уменьшить приблизительно до 20 нм при 30 кэВ.
Рис. 7. Схематическое изображение жидкометаллической ионной пушки (LMIS); (a) ионы металла; (b) экстрактор; (c) пленка жидкого металла; (d) капиллярная трубка; (e) жидкий металл; (f) игла. Двулучевая методика для времяпролетных ВИМС. Из-за их меньшего рабочего цикла времяпролетные установки менее подходят для исследований по получению распределений по глубине. Если используется только один точно сфокусированный импульсный источник, образец бомбардируется первичными ионами в течение только 0.1 % времени. Поэтому, требуется значительное время, чтобы достигнуть более глубоких областей. Но при помощи второго ионного источника, работающего в противоцикле к "измеряющему" лучу, без приложения ускоряющего потенциала, можно существенно увеличить скорость травления. Одно из преимуществ двулучевой методики заключается в том, что распыление для измерения и распыление для удаления материала не связаны. Поэтому диаметр пучка, энергия, масса, и угол "травящей" пушки могут быть оптимизированы независимо от "измеряющего" источника. Недостаток заключается в том, что атомы распыляемые на стадии травления не анализируются. Все оптические колонны ионных пушек обеспечены пластинами отклонения, позволяющими сканировать пучком по областям поверхности, от нескольких квадратных микрон до нескольких квадратных миллиметров. Кроме того, колонны приспособлены к работе в импульсном режиме добавлением отклоняющих пластин, которые быстро перемещают луч поперек апертуры. Можно получать импульсы меньше 1 нс. |
|

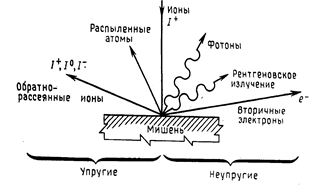
 (1)
(1) (2)
(2)